हालांकि सिलिकॉन और ग्लास वेफर्स दोनों का उद्देश्य "सफाई" करना है, लेकिन सफाई के दौरान आने वाली चुनौतियाँ और विफलता के तरीके काफी अलग हैं। यह अंतर सिलिकॉन और ग्लास के अंतर्निहित भौतिक गुणों और विशिष्ट आवश्यकताओं के साथ-साथ उनके अंतिम अनुप्रयोगों द्वारा संचालित सफाई की विशिष्ट "अवधारणा" के कारण उत्पन्न होता है।
सबसे पहले, आइए स्पष्ट कर लें: हम वास्तव में क्या साफ कर रहे हैं? इसमें कौन-कौन से प्रदूषक शामिल हैं?
संदूषकों को चार श्रेणियों में वर्गीकृत किया जा सकता है:
-
कण संदूषक
-
धूल, धातु के कण, कार्बनिक कण, अपघर्षक कण (सीएमपी प्रक्रिया से), आदि।
-
ये संदूषक शॉर्ट सर्किट या ओपन सर्किट जैसे पैटर्न संबंधी दोष उत्पन्न कर सकते हैं।
-
-
कार्बनिक संदूषक
-
इसमें फोटोरेसिस्ट के अवशेष, रेजिन एडिटिव्स, मानव त्वचा के तेल, सॉल्वेंट के अवशेष आदि शामिल हैं।
-
कार्बनिक संदूषक ऐसे आवरण बना सकते हैं जो नक़्क़ाशी या आयन प्रत्यारोपण में बाधा डालते हैं और अन्य पतली फिल्मों के आसंजन को कम करते हैं।
-
-
धातु आयन संदूषक
-
लोहा, तांबा, सोडियम, पोटेशियम, कैल्शियम आदि, जो मुख्य रूप से उपकरण, रसायन और मानव संपर्क से प्राप्त होते हैं।
-
अर्धचालकों में, धातु आयन "घातक" संदूषक होते हैं, जो निषिद्ध बैंड में ऊर्जा स्तर उत्पन्न करते हैं, जिससे रिसाव धारा बढ़ जाती है, वाहकों का जीवनकाल कम हो जाता है और विद्युत गुणों को गंभीर नुकसान पहुंचता है। कांच में, वे बाद में बनने वाली पतली फिल्मों की गुणवत्ता और आसंजन को प्रभावित कर सकते हैं।
-
-
देशी ऑक्साइड परत
-
सिलिकॉन वेफर्स के लिए: हवा में सतह पर सिलिकॉन डाइऑक्साइड (प्राकृतिक ऑक्साइड) की एक पतली परत स्वाभाविक रूप से बन जाती है। इस ऑक्साइड परत की मोटाई और एकरूपता को नियंत्रित करना कठिन है, और गेट ऑक्साइड जैसी प्रमुख संरचनाओं के निर्माण के दौरान इसे पूरी तरह से हटाना आवश्यक है।
-
कांच की पतली परतों के लिए: कांच स्वयं एक सिलिका नेटवर्क संरचना है, इसलिए "प्राकृतिक ऑक्साइड परत को हटाने" का कोई मुद्दा नहीं है। हालांकि, संदूषण के कारण सतह में बदलाव हो सकता है, और इस परत को हटाना आवश्यक है।
-

I. मुख्य लक्ष्य: विद्युत प्रदर्शन और भौतिक पूर्णता के बीच का अंतर
-
सिलिकॉन वेफ़र्स
-
सफाई का मुख्य उद्देश्य विद्युत दक्षता सुनिश्चित करना है। विनिर्देशों में आमतौर पर कणों की संख्या और आकार (जैसे, 0.1μm या उससे बड़े कणों को प्रभावी ढंग से हटाना आवश्यक है), धातु आयनों की सांद्रता (जैसे, Fe, Cu को 10¹⁰ परमाणु/सेमी² या उससे कम तक नियंत्रित करना आवश्यक है), और कार्बनिक अवशेषों के स्तर पर सख्त नियंत्रण शामिल होता है। सूक्ष्म स्तर का संदूषण भी सर्किट शॉर्ट सर्किट, लीकेज करंट या गेट ऑक्साइड की अखंडता में खराबी का कारण बन सकता है।
-
-
कांच के वेफर्स
-
सतह के रूप में, मुख्य आवश्यकताएँ भौतिक पूर्णता और रासायनिक स्थिरता हैं। विनिर्देशों में खरोंचों की अनुपस्थिति, न मिटने वाले दागों का अभाव और मूल सतह की खुरदरापन और ज्यामिति के रखरखाव जैसे व्यापक पहलुओं पर ध्यान केंद्रित किया जाता है। सफाई का मुख्य उद्देश्य दृश्य स्वच्छता और कोटिंग जैसी बाद की प्रक्रियाओं के लिए बेहतर आसंजन सुनिश्चित करना है।
-
II. पदार्थ की प्रकृति: क्रिस्टलीय और अनाकार के बीच मूलभूत अंतर
-
सिलिकॉन
-
सिलिकॉन एक क्रिस्टलीय पदार्थ है, और इसकी सतह पर स्वाभाविक रूप से एक असमान सिलिकॉन डाइऑक्साइड (SiO₂) ऑक्साइड परत बन जाती है। यह ऑक्साइड परत विद्युत प्रदर्शन के लिए खतरा पैदा करती है और इसे पूरी तरह और समान रूप से हटाना आवश्यक है।
-
-
काँच
-
कांच एक अनाकार सिलिका नेटवर्क है। इसकी मूल सामग्री की संरचना सिलिकॉन की सिलिकॉन ऑक्साइड परत के समान होती है, जिसका अर्थ है कि इसे हाइड्रोफ्लोरिक एसिड (HF) द्वारा आसानी से नष्ट किया जा सकता है और यह प्रबल क्षार क्षरण के प्रति भी संवेदनशील होता है, जिससे सतह की खुरदरापन या विकृति बढ़ जाती है। इस मूलभूत अंतर के कारण सिलिकॉन वेफर की सफाई में संदूषकों को हटाने के लिए हल्के, नियंत्रित क्षरण का उपयोग किया जा सकता है, जबकि कांच के वेफर की सफाई आधार सामग्री को नुकसान से बचाने के लिए अत्यंत सावधानी से की जानी चाहिए।
-
| सफाई का सामान | सिलिकॉन वेफर की सफाई | ग्लास वेफर की सफाई |
|---|---|---|
| सफाई लक्ष्य | इसमें इसकी अपनी प्राकृतिक ऑक्साइड परत शामिल है | सफाई विधि का चयन करें: आधार सामग्री की सुरक्षा करते हुए संदूषकों को हटाएँ |
| मानक आरसीए सफाई | - एसपीएम(H₂SO₄/H₂O₂): कार्बनिक/फोटोरेसिस्ट अवशेषों को हटाता है | मुख्य सफाई प्रवाह: |
| - एससी1(NH₄OH/H₂O₂/H₂O): सतह के कणों को हटाता है | कमजोर क्षारीय सफाई एजेंटइसमें कार्बनिक संदूषकों और कणों को हटाने के लिए सक्रिय सतह एजेंट मौजूद हैं। | |
| - डीएचएफ(हाइड्रोफ्लोरिक एसिड): प्राकृतिक ऑक्साइड परत और अन्य संदूषकों को हटाता है | प्रबल क्षारीय या मध्यम क्षारीय सफाई एजेंटइसका उपयोग धात्विक या गैर-वाष्पशील संदूषकों को हटाने के लिए किया जाता है। | |
| - एससी2(HCl/H₂O₂/H₂O): धातु संदूषकों को हटाता है | पूरे समय एचएफ से बचें | |
| प्रमुख रसायन | प्रबल अम्ल, प्रबल क्षार, ऑक्सीकारक विलायक | कम क्षारीय सफाई एजेंट, विशेष रूप से हल्के संदूषण को हटाने के लिए तैयार किया गया है। |
| शारीरिक सहायता | डीआयनीकृत जल (उच्च शुद्धता वाले कुल्ला के लिए) | अल्ट्रासोनिक, मेगासोनिक धुलाई |
| सुखाने की तकनीक | मेगासोनिक, आईपीए वाष्प सुखाने | धीमी सुखाने की प्रक्रिया: धीमी लिफ्ट, आईपीए वाष्प सुखाने की प्रक्रिया |
III. सफाई समाधानों की तुलना
उपर्युक्त लक्ष्यों और भौतिक विशेषताओं के आधार पर, सिलिकॉन और ग्लास वेफर्स के लिए सफाई समाधान भिन्न होते हैं:
| सिलिकॉन वेफर की सफाई | ग्लास वेफर की सफाई | |
|---|---|---|
| सफाई उद्देश्य | वेफर की मूल ऑक्साइड परत सहित पूरी तरह से हटाना। | चयनात्मक निष्कासन: सब्सट्रेट की सुरक्षा करते हुए संदूषकों को हटा दें। |
| विशिष्ट प्रक्रिया | मानक आरसीए क्लीन:•एसपीएम(H₂SO₄/H₂O₂): भारी कार्बनिक पदार्थों/फोटोरेसिस्ट को हटाता है •एससी1(NH₄OH/H₂O₂/H₂O): क्षारीय कणों को हटाना •डीएचएफ(पतला HF): प्राकृतिक ऑक्साइड परत और धातुओं को हटाता है •एससी2(HCl/H₂O₂/H₂O): धातु आयनों को हटाता है | सफाई की विशिष्ट प्रक्रिया:•हल्का क्षारीय क्लीनरकार्बनिक पदार्थों और कणों को हटाने के लिए सर्फेक्टेंट के साथ •अम्लीय या उदासीन सफाईकर्मीधातु आयनों और अन्य विशिष्ट संदूषकों को हटाने के लिए •पूरी प्रक्रिया के दौरान एचएफ से बचें |
| प्रमुख रसायन | प्रबल अम्ल, प्रबल ऑक्सीकारक, क्षारीय विलयन | हल्के क्षारीय क्लीनर; विशेष तटस्थ या हल्के अम्लीय क्लीनर |
| शारीरिक सहायता | मेगासोनिक (उच्च दक्षता, कोमल कण निष्कासन) | अल्ट्रासोनिक, मेगासोनिक |
| सुखाने | मारंगोनी का सूखना; आईपीए वाष्प सुखाने | धीमी गति से सुखाने की विधि; आईपीए वाष्प सुखाने की विधि |
-
ग्लास वेफर सफाई प्रक्रिया
-
वर्तमान में, अधिकांश कांच प्रसंस्करण संयंत्र कांच की भौतिक विशेषताओं के आधार पर सफाई प्रक्रियाओं का उपयोग करते हैं, जो मुख्य रूप से कमजोर क्षारीय सफाई एजेंटों पर निर्भर करती हैं।
-
सफाई एजेंट की विशेषताएं:ये विशेष सफाई एजेंट आमतौर पर कम क्षारीय होते हैं, जिनका pH लगभग 8-9 होता है। इनमें आमतौर पर सर्फेक्टेंट (जैसे, एल्काइल पॉलीऑक्सीएथिलीन ईथर), धातु चेलेटिंग एजेंट (जैसे, HEDP) और कार्बनिक सफाई सहायक पदार्थ होते हैं, जिन्हें तेल और उंगलियों के निशान जैसे कार्बनिक दूषित पदार्थों को पायसीकृत और विघटित करने के लिए डिज़ाइन किया गया है, जबकि कांच की सतह पर इनका संक्षारण न्यूनतम होता है।
-
प्रक्रिया प्रवाह:सामान्य सफाई प्रक्रिया में कमरे के तापमान से लेकर 60°C तक के तापमान पर कम सांद्रता वाले क्षारीय सफाई एजेंटों का उपयोग किया जाता है, साथ ही अल्ट्रासोनिक सफाई भी शामिल होती है। सफाई के बाद, वेफर्स को शुद्ध पानी से कई बार धोया जाता है और धीरे-धीरे सुखाया जाता है (जैसे, धीमी गति से उठाना या आईपीए वाष्प से सुखाना)। यह प्रक्रिया कांच के वेफर्स की दृश्य स्वच्छता और सामान्य स्वच्छता संबंधी आवश्यकताओं को प्रभावी ढंग से पूरा करती है।
-
-
सिलिकॉन वेफर सफाई प्रक्रिया
-
सेमीकंडक्टर प्रोसेसिंग के लिए, सिलिकॉन वेफर्स आमतौर पर मानक आरसीए सफाई से गुजरते हैं, जो एक अत्यधिक प्रभावी सफाई विधि है जो सभी प्रकार के संदूषकों को व्यवस्थित रूप से संबोधित करने में सक्षम है, यह सुनिश्चित करते हुए कि सेमीकंडक्टर उपकरणों के लिए विद्युत प्रदर्शन आवश्यकताओं को पूरा किया जाता है।
-
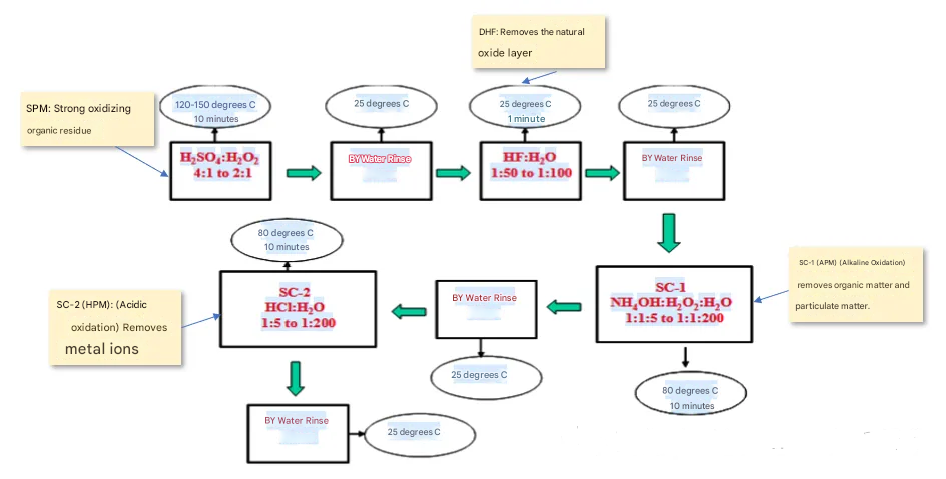
IV. जब कांच उच्च “स्वच्छता” मानकों को पूरा करता है
जब ग्लास वेफर्स का उपयोग ऐसे अनुप्रयोगों में किया जाता है जिनमें कणों की संख्या और धातु आयन स्तरों की सटीक माप आवश्यक होती है (उदाहरण के लिए, अर्धचालक प्रक्रियाओं में सब्सट्रेट के रूप में या उत्कृष्ट पतली फिल्म निक्षेपण सतहों के लिए), तो आंतरिक सफाई प्रक्रिया पर्याप्त नहीं रह जाती है। ऐसे में, संशोधित आरसीए सफाई रणनीति को अपनाते हुए, अर्धचालक सफाई सिद्धांतों को लागू किया जा सकता है।
इस रणनीति का मूल उद्देश्य कांच की संवेदनशील प्रकृति को ध्यान में रखते हुए मानक आरसीए प्रक्रिया मापदंडों को सरल और अनुकूलित करना है:
-
जैविक संदूषकों को हटाना:एसपीएम घोल या कम विषैले ओजोन जल का उपयोग तीव्र ऑक्सीकरण के माध्यम से कार्बनिक दूषित पदार्थों को विघटित करने के लिए किया जा सकता है।
-
कणों को हटाना:कणों को हटाने के लिए, साथ ही कांच पर होने वाले क्षरण को कम करने के लिए, अत्यधिक तनु SC1 विलयन का उपयोग कम तापमान और कम उपचार समय पर किया जाता है, ताकि इसके विद्युतस्थैतिक प्रतिकर्षण और सूक्ष्म-नक़्क़ाशी प्रभावों का लाभ उठाया जा सके।
-
धातु आयन निष्कासन:धातु संदूषकों को कीलेशन के माध्यम से हटाने के लिए तनु SC2 विलयन या साधारण तनु हाइड्रोक्लोरिक अम्ल/तनु नाइट्रिक अम्ल विलयन का उपयोग किया जाता है।
-
सख्त प्रतिबंध:कांच की सतह को संक्षारित होने से बचाने के लिए डीएचएफ (डाई-अमोनियम फ्लोराइड) का उपयोग बिल्कुल नहीं करना चाहिए।
इस पूरी संशोधित प्रक्रिया में, मेगासोनिक तकनीक को शामिल करने से नैनो-आकार के कणों को हटाने की दक्षता में काफी वृद्धि होती है और यह सतह के लिए अधिक सौम्य है।
निष्कर्ष
सिलिकॉन और ग्लास वेफर्स की सफाई प्रक्रियाएं उनके अंतिम अनुप्रयोग की आवश्यकताओं, भौतिक गुणों और भौतिक एवं रासायनिक विशेषताओं के आधार पर रिवर्स इंजीनियरिंग का अपरिहार्य परिणाम हैं। सिलिकॉन वेफर की सफाई विद्युत प्रदर्शन के लिए "परमाणु-स्तर की स्वच्छता" प्राप्त करने पर केंद्रित होती है, जबकि ग्लास वेफर की सफाई "परिपूर्ण, अक्षतिग्रस्त" भौतिक सतहों को प्राप्त करने पर केंद्रित होती है। जैसे-जैसे ग्लास वेफर्स का उपयोग सेमीकंडक्टर अनुप्रयोगों में बढ़ता जा रहा है, उनकी सफाई प्रक्रियाएं पारंपरिक कमजोर क्षारीय सफाई से आगे बढ़कर अधिक परिष्कृत, अनुकूलित समाधानों जैसे कि संशोधित आरसीए प्रक्रिया को विकसित करेंगी ताकि उच्च स्वच्छता मानकों को पूरा किया जा सके।
पोस्ट करने का समय: 29 अक्टूबर 2025
